MMC > MNOICトップページ > 設備の概要
設備概要
MNOIC研究支援可能な設備の概要
| 装置番号 | 装置名称 | 外観 | メーカー・型式名 | 概略仕様 |
|---|---|---|---|---|
| 【 洗浄装置 】 | ||||
| 1 | ウェハディップ洗浄装置 | 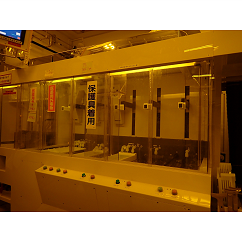 |
㈱セミコンクリエイト・SCCH-1174 | ウェハ寸法:8、12インチウェハ、機能:ウェットエッチング液による5枚バッチ処理ディップ洗浄・スピン乾燥、前処理用汎用無機ドラフト付属、洗浄プロセス:硫酸/過酸化水素水、希釈フッ酸による洗浄と超純水リンス洗浄 |
| 2 | ウェハスピン洗浄装置 |  |
イーティーシステムエンジニアリング㈱/㈱日立ハイテクトレーディング・ ETS-9343-201 | ウェハ寸法:8、12インチウェハ、機能:ウェットエッチング液による枚葉処理スピン洗浄・乾燥、洗浄プロセス:アンモニア/過酸化水素水、塩酸/過酸化水素水、希釈フッ酸による洗浄と超純水リンス洗浄、ウェットアンローダー付属 |
| 3 | 有機ドラフト | 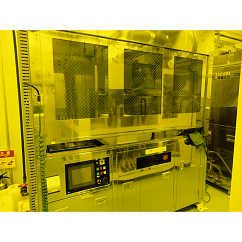 |
ジャパンクリエイト㈱・CDC-1800 | ウェハ寸法:8インチウェハ、 機能:ウェハの手動有機洗浄作業と有機溶剤含有塗布剤スピンコーティングが可能な局所排気装置、作業面幅1800mm |
| 4 | 異方性ウェットエッチング装置 |  |
㈱カナメックス・WEB-3-A200CBU | ウェハ寸法:8インチウェハ、 機能:恒温薬品槽へのウェハディッピングによるシリコン異方性エッチング、超純水リンス洗浄、5枚バッチ全自動搬送処理、ウェハ処理槽内搖動による均一エッチング、エッチング液:TMAH |
| 5 | IPAベーパー乾燥機 |  |
イーティーシステムエンジニアリング㈱/㈱日立ハイテクトレーディング・ETVD-200-11 | ウェハ寸法:8インチウェハ、 機能:ウェハを5枚バッチでIPAベーパー乾燥、薬液乾燥、IPA蒸気乾燥 |
| 58 | 無機ドラフト |  |
㈱セミコンクリエイト・SCCH-1174 | ウエハ寸法:8、12インチ、酸化膜・金属膜のエッチング、またRCA洗浄・HF洗浄など前洗浄(枚葉処理、5枚バッチ処理) 超純水洗浄は、一次水洗⇒二次水洗を行う 薬液は薬液毎の回収タンクに回収する |
| 77 | 2流体洗浄装置 |  |
アクテス京三(株)ADE-3000S | ウェハ寸法:個片から8インチまで 機能:純水のスプレーでパーティクルを除去する |
| 78 | リフトオフ装置 | 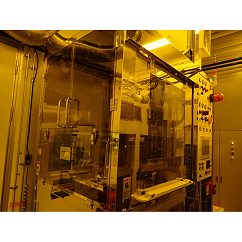 |
㈱ダルトン(MJ07-000) | ウエハサイズ:4,6,8インチ フォトマスク: 6,9インチ 剥離液:NMP(80℃,ヒートタンク循環) ダブルJETノズル:MAX 15MPa |
| 【 リソグラフィ装置 】 | ||||
| 6 | i-線ステッパ |  |
㈱ニコン/㈱ニコンテック・NSR-2205i11 | ウェハ寸法:8インチウェハ 機能:i-線(紫外線)によるレチクルパターンの1/5縮小投影露光 最小解像溝幅:0.5μm 使用レチクル:6インチ角、標準レジスト厚さ:1μm |
| 7 | マスク露光装置 | 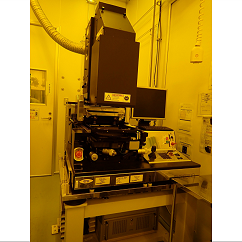 |
EVGジャパン㈱/㈱日放電子・EVG6200TB | ウェハ寸法:6、8インチウェハ、機能:ウェハへのマスクアライメント、1:1転写露光、ラージギャップ、高段差露光、裏面アライメント対応、露光モード:バキューム/ハードコンタクト/プロキシミティ露光、アライメント精度:±0.5μm以内、標準レジスト厚さ:1μm、10μm |
| 8 | マスクレス露光装置 |  |
東芝機械㈱・STG-4(DL) | ウェハ寸法:最大12インチウェハ、 機能:DMD光源によるパターン直描露光、描画エリア:最大500mm角、最小画素:1μm×1μm、最小描画ホール径:3μm |
| 59 | レジスト塗布現像装置 |  |
リソテックジャパン㈱・LITHOTRAC Dual-1000 | ウェハ寸法:4,8インチウェハ 機能:レジスト2種類選択塗布、アルカリ現像液(NMD-3)、HMDS処理、ベーク処理、自動搬送処理 |
| 76 | フォトリソ工程用オーブン |  |
ヤマト科学㈱・DE410 | ウェハ寸法:最大8インチ 機能:フォトリソのプリベークやポストベ |
| 【 エッチング装置 】 | ||||
| 17 | 金属膜ドライエッチング装置 | 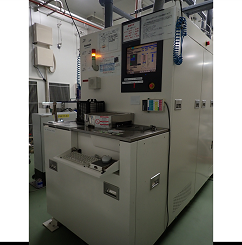 |
パナソニックファクトリーソリューションズ㈱・E-658-ICP MK6 | ウェハ寸法:8インチウェハ、 機能:ハロゲン系ガスの高密度ICPによる難加工金属膜のドライエッチング加工、ウェハの腐食防止アッシング加工、カセット・ツー・カセット搬送処理、エッチング終点判定機能付属 |
| 18 | Si酸化膜ドライエッチング装置 |  |
パナソニックファクトリーソリューションズ㈱・E-628-I MK6 | ウェハ寸法:8インチウェハ、 機能:フッ素系ガスによるICPドライエッチング、Si酸化膜・Si窒化膜の非ボッシュプロセスによるエッチング加工、カセット・ツー・カセット搬送処理、エッチング終点判定機能付属 |
| 19 | 8"Si深掘ドライエッチング装置 |  |
SPPテクノロジーズ㈱/住友精密工業㈱・ASE-Pegasus200 | ウェハ寸法:8インチウェハ、 機能:フッ素系ガスのICP高密度プラズマによるドライエッチング加工、ボッシュプロセス深堀加工、カセット・ツー・カセット搬送処理、ウェハエッジ保護機能付属 |
| 20 | 12"Si深掘ドライエッチング装置 |  |
SPPテクノロジーズ㈱/住友精密工業㈱・ASE-Pegasus300 | ウェハ寸法:12インチウェハ、 機能:フッ素系ガスのICP高密度プラズマによるドライエッチング加工、ボッシュプロセス深堀加工、カセット・ツー・カセット搬送処理 |
| 21 | 犠牲層ドライエッチング装置 |  |
memsstar?/キャノンマーケティングジャパン㈱・SVR-vHF | ウェハ寸法:4、6、8インチウェハ、 機能:フッ酸ベーパーによるSi酸化膜犠牲層のドライエッチング、終点判定機能付属 |
| 22 | アッシャー | 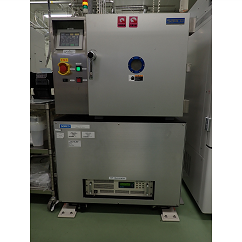 |
サムコ㈱・PC-1100 | ウェハ寸法:8、12インチウェハ、 機能:ウェハの酸素プラズマアッシング、2バッチ処理可能 |
| 【 成膜装置 】 | ||||
| 13 | 酸化炉 |  |
光洋サーモシステム㈱・VF-3000 | ウェハ寸法:8インチウェハ、機能:Siウェハへの熱酸化膜形成、25枚バッチのカセット・ツー・カセットウェハ搬送処理、縦型チューブ仕様、水素ガス燃焼による水蒸気利用ウェット酸化とドライ酸化、酸化温度:最高1150℃ |
| 11 | Si酸化膜プラズマCVD装置 |  |
サムコ㈱・PD-330STL | ウェハ寸法:8、12インチウェハ、 機能:TEOS液体ソースのプラズマCVDによるSi酸化膜低温形成、成膜温度:150℃ |
| 15 | Si窒化膜減圧CVD装置 | 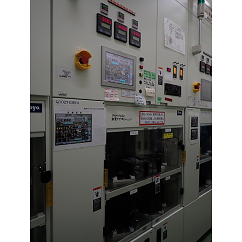 |
光洋サーモシステム㈱・VF-3000LP | ウェハ寸法:8インチウェハ、 機能:減圧CVDによるSiウェハへの窒化膜形成、25枚バッチのカセット・ツー・カセットウェハ搬送処理、縦型チューブ仕様、内部応力制御成膜可能 |
| 16 | ポリSi減圧CVD装置 |  |
光洋サーモシステム㈱・VF-3000LP | ウェハ寸法:8インチウェハ、 機能:減圧CVDによるSiウェハへのリンドープ・ポリシリコン膜形成、25枚バッチのカセット・ツー・カセットウェハ搬送処理、縦型チューブ仕様 |
| 12 | スパッタ |  |
㈱アルバック/アルバックイーエス㈱・SME-200 | ウェハ寸法:8インチウェハ、機能:3チャンバ構成マグネトロンスパッタによるウェハへの各種金属膜、絶縁膜形成、ターゲットへのDC/RF電圧選択印加可能、標準成膜材料:Au、Pt、Cr、Ti、AL、Mo、W、SiO2、ALN |
| 36 | 電子ビーム/抵抗蒸着装置 | 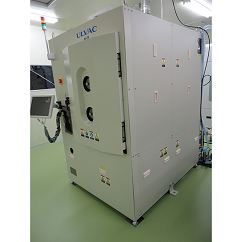 |
㈱アルバック/アルバックイーエス㈱・ei-5 | ウェハ寸法:8、12インチウェハ、 機能:電子ビーム及び抵抗加熱方式真空蒸着、8インチ3枚バッチ、12インチ枚葉処理、標準成膜材料:AL、Au、Cr、成膜速度例:30-60nm/分 |
| 72 | 小口径スパッタ |  |
お問合せください | |
| 【 加工装置 】 | ||||
| 32 | ブレードダイサー |  |
㈱ディスコ・DAD3350 | ウェハ寸法:最大12インチウェハ 機能:ダイヤモンドブレードによるウェハ切断、 ステージ分解能:0.1μm、 送り速度:0.1-600mm/s |
| 33 | レーザーステルスダイサー |  |
㈱ディスコ・DFL7340 | ウェハ寸法:3-8インチウエハ、 機能:レーザによる低ダメージ・ドライ切断、カセット・ツー・カセット搬送処理、ステージ分解能:0.1μm、送り速度:1-1000mm/s |
| 37 | 熱処理装置 | 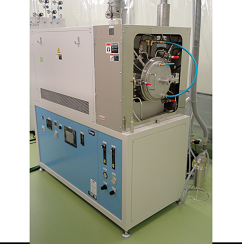 |
光洋サーモシステム㈱/ヤマト科学㈱・MT-10X8-V | ウェハ寸法:8インチウェハ、機能:真空及びN2ガス雰囲気での熱処理、10枚バッチ処理、横型、真空チューブ仕様、最大加熱温度:600℃ |
| 38 | チップtoウェハ接合装置 |  |
ボンドテック㈱/丸紅情報システムズ㈱・CW-1000M12 | ウェハ寸法:4、6、8、12インチ 機能:チップ/ウェハ接合、チップ寸法:1-20mm角 接合温度:60-400℃ アライメント精度:±0.5μm(繰り返し精度) |
| 39 | ウェハtoウェハ接合装置 |  |
ボンドテック㈱/丸紅情報システムズ㈱・WAP-1000M | ウェハ寸法:4、6、8インチ、機能:ウェハ/ウェハ低温接合(陽極接合、プラズマ接合)、接合チャンバ内アライメント機能付属、接合温度:400℃以下(大気圧では250℃以下)、アライメント精度:±0.5μm(繰り返し精度)、プラズマ処理モジュール付属 |
| 41 | 光表面処理装置 | 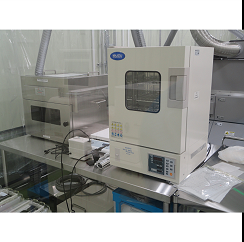 |
セン特殊光源㈱・PL2003N | ウェハ寸法:8インチウェハ、機能:DeepUV 光照射、ベーキング処理 |
| 42 | 12”ウェハ常温接合装置 |  |
ニデックマシンツール㈱MWB-12ST | ウェハ寸法:最大12インチウェハ 機能:FAB照射によるウェハ表面クリーニングと接合を真空チャンバ内で連続処理できる。赤外線カメラによるアライメント可能 最大印加可能荷重:200,000N |
| 60 | イオンミリング装置 | 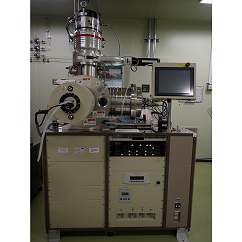 |
伯東㈱・161BE-KDC160 | ウェハ寸法:8インチ 機能:試料の表面にアルゴンイオンビームを照射し、表面を削ることで、試料の断面観察や表面加工を行う |
| 74 | ダイシングフィルム貼付装置 |  |
㈱テクノビジョン・FM224 NECエンジニアリング㈱・VTL-100 | ウェハ寸法:8インチ 機能:ダイシングフィルムを貼る |
| 75 | 保護フィルム貼付装置 |  |
㈱テクノビジョン・FM-2248 | ウェハ寸法:8インチ 機能:ウェハにフィルムを貼る |
| 79 | レーザマーカー | 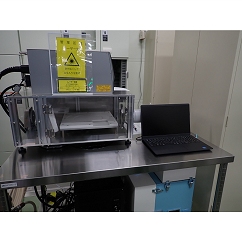 |
サンエム精機㈱(レーザー:キーエンスMDU-1000C) | ウエハサイズ:8,12インチ レーザー波長:355nm 印字分解能:2μm 除電器併設 |
| 80 | チップソーター | 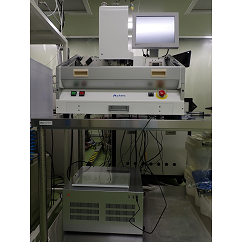 |
アクテス京三㈱(ACT-1000) | 有効作業エリア:200×200mm 把持ヘッド開閉:0~4mm(微小段差付) 9~13mm(幅広) 把持力センサ:MAX 100g、8”グリップリング |
| 【 評価装置 】 | ||||
| 10 | 光学顕微鏡(3D) |  |
オリンパス㈱/㈱菱光社・MX61L-F | ウェハ寸法:最大12インチウェハ 機能:光学顕微観察、紫外線フィルター・画像処理機能付属 倍率:50-1000倍 ステージストローク:350×300mm |
| 23 | 光学検査顕微鏡 |  |
㈱モリテックス・Irise | ウェハ寸法:4、6、8インチウェハ、 機能:光学顕微鏡観察によるウェハ自動欠陥検査、測定エリア:最大8インチ、最小検出欠陥寸法:2μm |
| 24 | 段差測定器 |  |
ケーエルエー・テンコール㈱/ヤマト科学㈱・P16 | ウェハ寸法:8インチウェハ、 機能:触針式ウェハ表面形状評価、表面プロファイル及びストレスマッピング機能、先端角20度の鋭角スタイラス付属、測定レンジ:5-300μm、再現性:最小レンジで1nmσ |
| 25 | エリプソメーター |  |
ハイソル㈱/㈱日立ハイテクトレーディング・MARY-102SM | ウェハ寸法:8インチウェハ、 機能:自動エリプソメトリー、膜厚測定精度:±1nm/100nm厚さ |
| 26 | 膜厚測定器 | 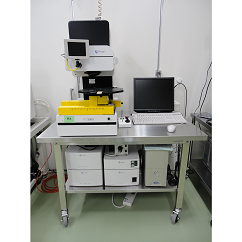 |
大塚電子㈱/ヤマト科学㈱・FE3000SA | ウェハ寸法:8、12インチウェハ、 機能:反射分光方式非接触膜厚測定、分光曲線フィッティングによる屈折率及び膜厚測定、測定エリア:8インチ径以内、測定膜厚:10nm-40μm、繰り返し精度:0.1% |
| 27 | ウェハ塵埃検査装置 |  |
㈱トプコンテクノハウス/㈱菱光社・WM-7C | ウェハ寸法:8インチウェハ、 機能:ウェハ面上の塵埃数測定、ステージ移動によるマッピング及び粒子径分布ヒストグラム表示、カセット・ツー・カセット搬送処理、検出粒子径:0.079-5.0μ |
| 28 | 干渉型表面形状評価装置 |  |
ブルカーAXS㈱/㈱日立ハイテクトレーディング・ContourGT-X3 | ウェハ寸法:最大8インチウェハ、機能:白色干渉型非接触表面プロファイル測定、垂直分解能:0.1nm |
| 29 | シート抵抗プローバー |  |
ナプソン㈱/㈱日立ハイテクトレーディング・RT-3000(S)/RG-80N | ウェハ寸法:最大8インチウェハ、 機能:セミオート4探針抵抗率/シート抵抗測定、測定範囲:1m-10MΩ/□、測定精度:±1%以下 |
| 30 | 赤外線レーザ顕微鏡 |  |
オリンパス㈱・LEXT OLS3000-IR | ウェハ寸法:最大12インチウェハ、 機能:赤外線レーザによる共焦点顕微観察、各種表面プロファイル分析 |
| 31 | レーザ顕微鏡 |  |
オリンパス㈱・LEXT OLS4000 | ウェハ寸法:最大12インチウェハ、 機能:可視光線レーザによる共焦点顕微観察、各種表面プロファイル分析、光源波長:405nm |
| 34 | 光学顕微鏡 |  |
オリンパス㈱/㈱菱光社・MX61L-F | ウェハ寸法:最大12インチウェハ 機能:光学顕微観察、紫外線フィルター・画像処理機能付属 倍率:50-1000倍 ステージストローク:350×300mm |
| 43 | 測長SEM |  |
㈱日立ハイテクノロジーズ・S-9200 | ウェハ寸法:8インチウェハ(ノッチタイプ)片面鏡面研摩ウェハ対応 ウエハ厚:625~725um、機能:走査型電子顕微鏡による寸法測定、測長範囲:0.1-2.0μm、解像分解能:3nm、観察倍率:1000-300000倍 |
| 44 | 分析SEM |  |
㈱日立ハイテクノロジーズ・S-3700N | ウェハ寸法:8インチウェハ(ノッチタイプ)片面鏡面研摩ウェハ対応 ウエハ厚:625~725um、機能:走査型電子顕微鏡による寸法測定、測長範囲:0.1-2.0μm、解像分解能:3nm、観察倍率:1000-300000倍 |
| 45 | 超音波顕微鏡 |  |
㈱日本レーザー・SAM300 | ウェハ寸法:8、12インチ、機能:接合されたウエハなどの内部欠陥(ボイド、クラック、剥離など)の観測 |
| 46 | 赤外線顕微鏡 |  |
浜松ホトニクス㈱・C9597-11 | ウェハ寸法:8インチ、 機能:赤外線光源による顕微観察、画像処理機能付属 |
| 47 | 薄膜応力評価装置 |  |
東朋テクノロジー㈱/ヤマト科学㈱・FLX-2320-S | ウェハ寸法:8インチウェハ、 機能:レーザ光によるウェハ反り量の非接触計測、内部応力値への換算評価、加温中のin-situ計測による応力変化の温度履歴評価機能付属、最高加熱温度:600℃ |
| 48 | X線CT評価装置 |  |
Xradia Inc./キャノンマーケティングジャパン㈱・MicroXCT-400 | ウェハ寸法:8、12インチウェハ、 機能:X線CTスキャン顕微鏡観察、チップホルダ付属、取込立体画像/CAD図形変換、観察エリア:最大8インチ、最高分解能:1μm |
| 49 | テスタープローバー |  |
エスティケイテクノロジー㈱・TEMEON | ウェハ寸法:8インチウェハ、 機能:プローブカードによる大気中でのウェハレベル電気的特性評価、セミオートウェハ搬送処理、容量計測・周波数解析機能、音響加振機能付属 |
| 50 | 光学顕微鏡(3B) |  |
㈱ハイロックス/ヤマト科学㈱・KH-1300 | ウェハ寸法:最大12インチウェハ 機能:長焦点深度の光学顕微観察、画像処理機能付属 倍率:35-2500倍、ステージストローク:300×250mm |
| 51 | 圧電定数評価装置 | 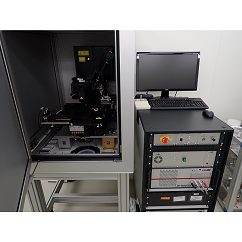 |
お問合せ下さい | |
| 53 | ダイシェアテスタ |  |
ノードソン㈱・4000Plus | ウェハ寸法:最大4インチウェハ 機能:接合部にせん断方向の力を加え、破壊する際の荷重を測定 最大力:200㎏ |
| 69 | 自動光学顕微鏡 | 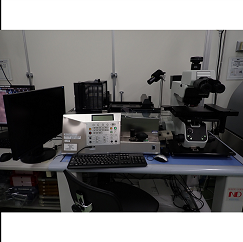 |
㈱エビデント(MX61-F-5) | ウェハ寸法:8インチウェハ 機能:光学顕微観察、測長システム付属 倍率:50-1000倍 |
| 70 | レーザードップラー測定器 |  |
ネオアーク㈱・MLD-221V | ウェハ寸法:最大8インチウェハ 励振:半導体レーザー(可変) 計測:He-Neレーザー 共振周波数測定:アンリツ ネットワークアナライザ MS4630B |
| 71 | フーリエ変換赤外分光装置 |  |
Nicolet iN10顕微FT-IR | 可視画像 / 赤外スペクトル同時観察 (TruView) 分析領域 最小100 μ m□ 計測可能Si膜厚 3~750μ m |
| 73 | マニュアルプローバ | 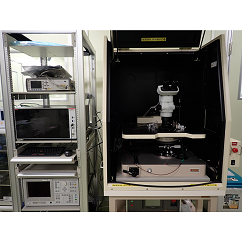 |
㈱日本マイクロニクス(半導体プローバ) | ウェハ寸法:最大8インチウェハ 端子数:SMU1~3,GND ステージ温度:40~200℃(加温時) プローブ針:パラジウム合金(Auパッド用),タングステン |
前工程MEMSライン(3DCR配置図)
MEMS前工程に必要な装置を完備しています。
クリーンルームは約350㎡、クラス1000。
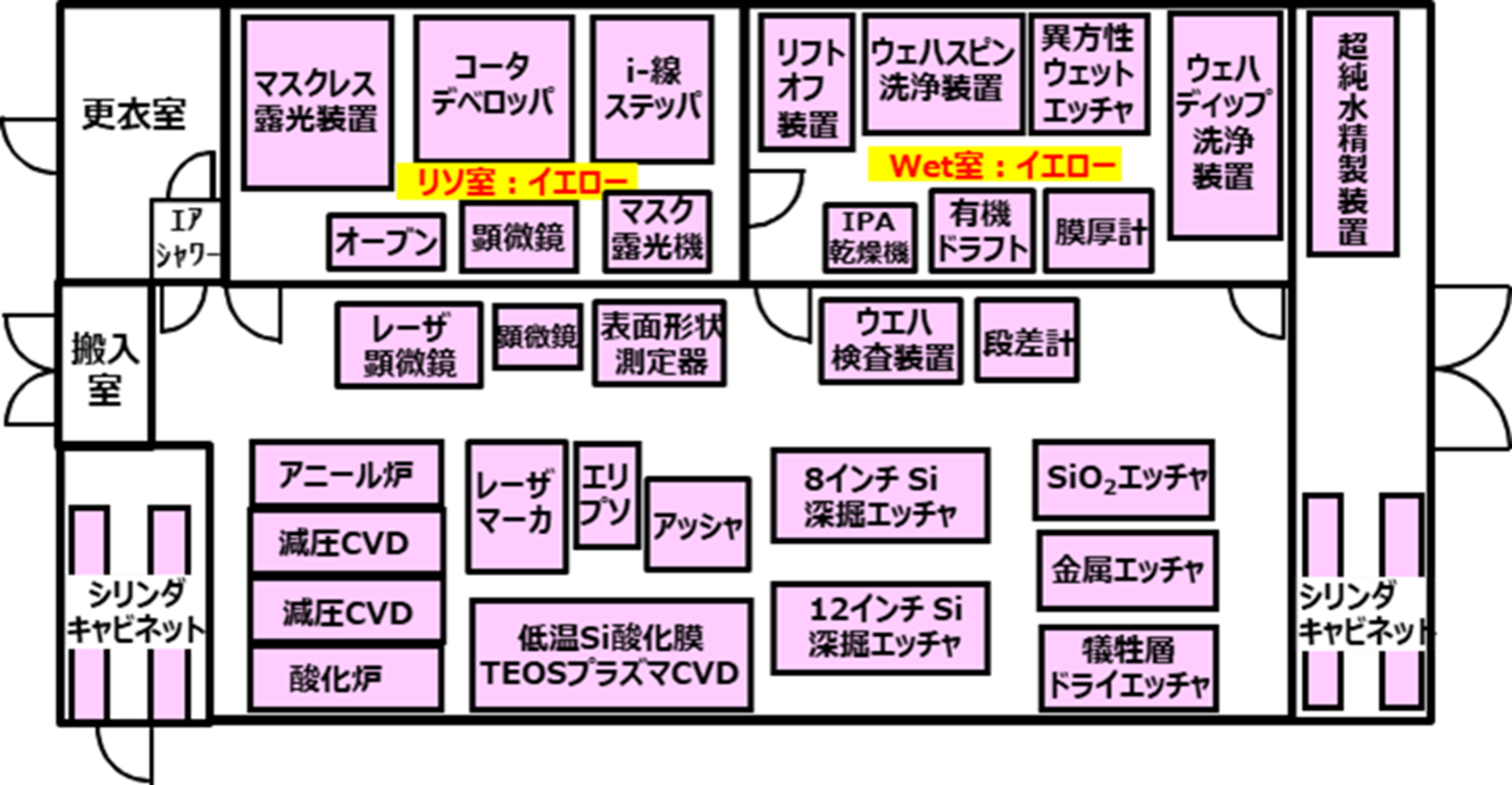
後工程MEMSライン(3BCR配置図)
MEMS後工程、評価に必要な装置を完備しています。
クリーンルームは約150㎡、クラス1000。